单晶硅片——绝缘片(SOI)
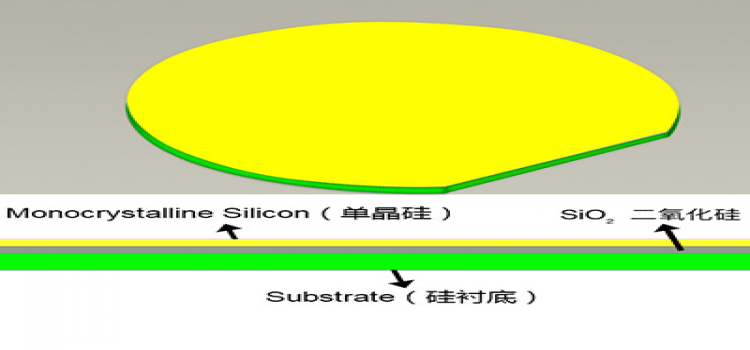
绝缘片(SOI)
为了提高集成电路的集成度和速度,降低功耗必须缩小器件的尺寸。但当器件的尺寸缩小到亚微米范围以内时,常规的结构就不适应了,从而导致SOI( Silicon On Insulator或Semi- conductor On Insulator)结构的发展,也就是把器件制作在绝缘衬底上生长的硅单晶层上。SOI结构开始是针对亚微米CMOS器件提出来以取代不适合要求的常规结构以及已经应用的sos结构(sos可以看成是SOI的一种形式),但SOI结构很快也成为实现高速集成电路及三维集成电路的新途径(但不是所有的SOI结构都可以用来做三维集成电路),是当前半导体材料研究的一个热点问题。
| Diameter | 4″ | 5″ | 6″ | 8″ | |
| Device Layer | Dopant | Boron, Phos, Arsenic, Antimony, Undoped | |||
| Orientation | <100>, <111> | ||||
| Type | SIMOX, BESOI, Simbond, Smart-cut | ||||
| Resistivity | 0.001-20000 Ohm-cm | ||||
| Thickness (um) | 0.2-150 | ||||
| The Uniformity | <5% | ||||
| BOX Layer | Thickness (um) | 0.4-3 | |||
| Uniformity | <2.5% | ||||
| Substrate | Orientation | <100>, <111> | |||
| Type/Dopant | P Type/Boron , N Type/Phos, N Type/As, N Type/Sb | ||||
| Thickness (um) | 300-725 | ||||
| Resistivity | 0.001-20000 Ohm-cm | ||||
| Surface Finished | P/P, P/E | ||||
| Particle | <10@.0.3um | ||||
SOI结构的优点大致可以归纳为如下几个方面:
SOI与SOS相比,SOI材料的完整性比sos好得多,比SOS应用的范围也广泛CMOS电路中采用SOI结构,可以减少掩蔽次数,也不需要隔离扩散,使线路布局简化,提高集成度。SOS中Si与Al2O3的热膨胀系数不匹配,硅层内有压缩应力。此外,SO1的功耗和衬底成本都比SOS低得多,SOS没有实现三维器件结构功能。
从目前情况来看,有的SOI技术已初步走向实用化,只要能进一步克服工艺和材料质量问题,实用化是没有问题的,某些SOI技术可以用于三维IC的制造SOI结构材料制备的方法有很多种,下面简要介绍几种主要的方法:
2.CVD横向生长
3.氧离子注入形成SOI结构
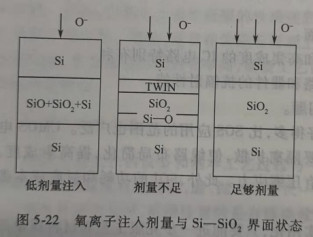
4.硅片面键合法
SOI技术已经研究很多年,取得一些结果,各先进工业国都投入不少力量进行研究,一旦获得突破性的进展,其应用前景是十分广阔的。
更多产品信息欢迎您进店选购!
关于国瑞升GRISH®–精密抛光材料专家&专注精密抛光20年
北京国瑞升科技股份有限公司成立于2001年6月,是国内专业从事研发、生产、经营超精密研磨抛光材料的国家级高新技术企业,是具有多项国际国内自主知识产权、多年产品技术研发经验和众多客户应用实践沉淀的业界先驱。
( https://www.bjgrish.com )
国瑞升GRISH®以精准服务为客户提供专业化、定制化的研磨抛光解决方案,以及多种配套化、系列化的精密研磨抛光材料产品、工艺和设备,专注解决客户超精密研磨抛光的高端需求,助力客户成功!
其中国瑞升GRISH®研发生产的超精密抛光膜&抛光带、静电植砂研磨带&抛光带、3D立体凹凸磨料、单晶&多晶&类多晶–金刚石微粉及对应研磨液、CMP抛光液、研磨助剂等多种超精密抛光耗材,广泛应用于光通信、汽车、半导体、LED、蓝宝石、精密陶瓷、LCD、3C电子、辊轴、口腔医疗等多个行业,并已出口至美国、英国、德国、俄罗斯、日本、韩国、印度、巴西等多个国家和地区。
欢迎您关注
国瑞升GRISH®
以专业化、系列化、
配套化、定制化的产品,
精准服务,助客户成功!








